
Precision casting with excellent quality
Integrated research and development, manufacturing, sales, and technical services of laboratory scientific instruments and intelligent equipment
National Consultation Hotline 15738867410

Integrated research and development, manufacturing, sales, and technical services of laboratory scientific instruments and intelligent equipment
National Consultation Hotline 15738867410
15738867410
Greenland Binhu International City (District 1), Erqi District, Zhengzhou City, Henan Province
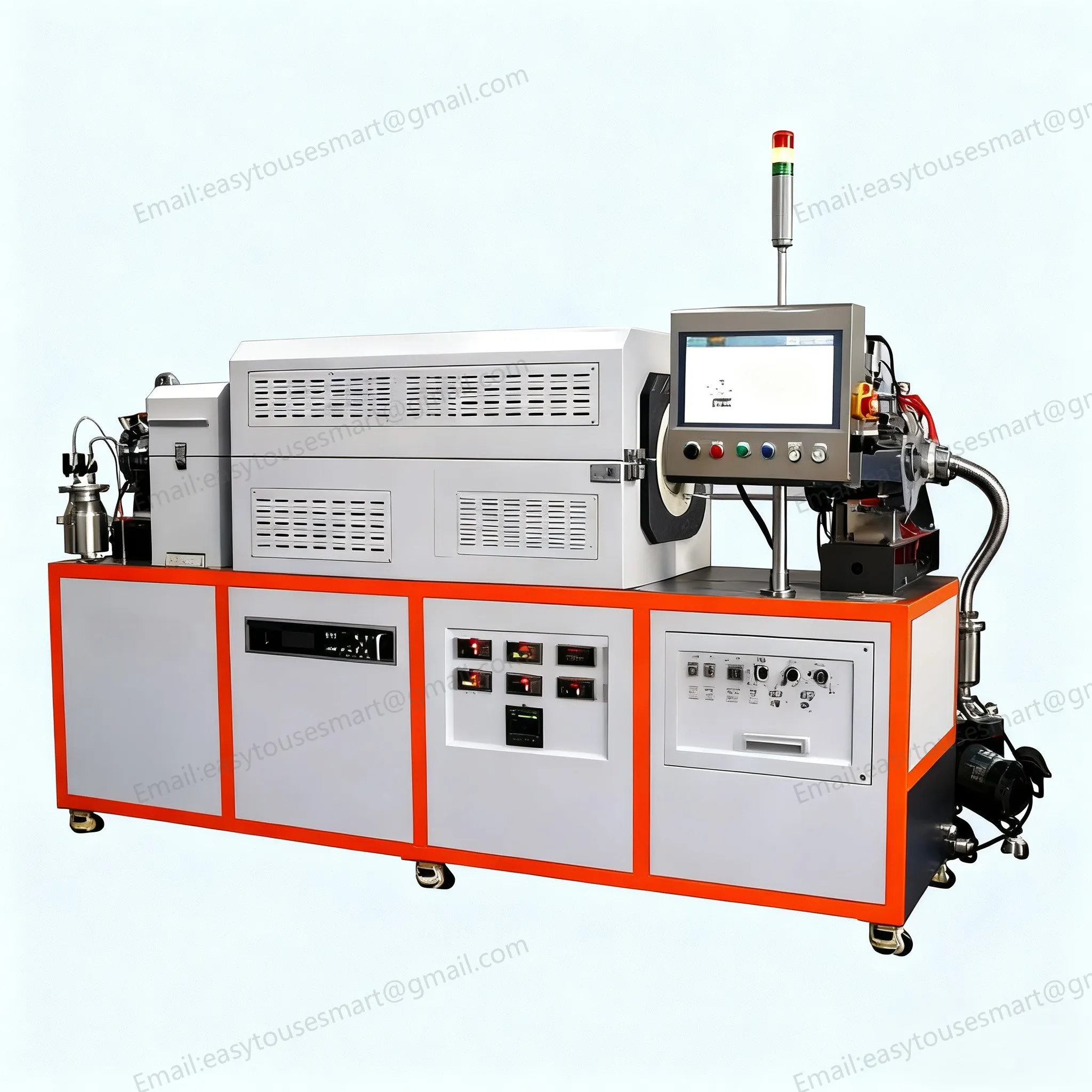
Details


The D210 intelligent PECVD system is a compact plasma-enhanced chemical vapor deposition device for laboratory research and small sample preparation. Adopting a desktop integrated structure, it occupies less space and runs stably.
With RF plasma activation, it assists film forming at 400–600°C, and optional high-temperature heating up to 1200°C meets diverse experimental needs. It is widely used for preparing graphene, DLC films, silicon-based thin films, dielectric layers, carbon nanomaterials and optical functional coatings. It is commonly adopted by universities, research institutions and enterprise laboratories for new material testing and process research.
It features an integrated desktop layout, suitable for conventional laboratory platforms. Equipped with a 13.56 MHz RF power supply (0–300W) and automatic impedance matching unit, it forms stable plasma inside the quartz cavity. Plasma effectively reduces reaction energy consumption, realizing low-temperature deposition and protecting temperature-sensitive substrates while improving film compactness and binding force.
Optional single/dual independent PID temperature control, with optional maximum temperature of 1000°C or 1200°C, control accuracy ±1℃. It supports multi-segment programmable temperature procedures, matched with plasma linkage control. Real-time data recording ensures stable and repeatable experimental results.
Configured with 4–6 expandable gas pipelines and high-precision MFC flow controllers, it achieves accurate gas proportioning and uniform mixing. The pre-mixing structure stabilizes the internal cavity environment and maintains consistent thin film preparation conditions.
It supports normal pressure and low-pressure plasma processes. The standard vacuum unit reaches a vacuum level of 5×10⁻³ Pa, with an upgraded molecular pump available for higher vacuum demand. Equipped with high-precision pressure detection and adjustable valves, it maintains stable working pressure for material growth.
Multiple safety interlock functions include over-temperature cutoff, water flow monitoring, overcurrent prevention and radio frequency protection. Reserved external gas processing interfaces meet laboratory safety operation norms.
PLC combined with touch screen control realizes parameter display, process recipe storage and data export, with simple operation and clear data viewing.
Parameter Item | Specification |
Model | Smart-PECVD-D210 |
Heating Component | Silicon carbide rod / resistance wire optional |
Temperature Zone | Single / dual zone optional |
Max Temperature | 1000°C / 1200°C (optional) |
Constant Temperature Zone | ≥200mm |
Temperature Control Accuracy | ±1℃ |
Heating Rate | 0.1–20°C/min, programmable |
Plasma Unit | 13.56 MHz RF power, 0–300W adjustable, automatic impedance matching |
Reaction Cavity | High-purity quartz tube, multiple sizes optional, water-cooled quick-release flange |
Gas System | 4–6 channels (expandable), MFC precise flow control |
Standard Vacuum | ≤5×10⁻³ Pa |
Cooling Mode | Forced air cooling + water-cooled structure |
Control System | 7–10 inch touch screen + PLC, multi-program setting and fault self-checking |
Power Supply | AC 220V/380V, 50Hz, total power 3–6kW |
Overall Size | About 800×500×600mm (reference, subject to configuration) |
Low-temperature preparation of graphene and carbon-based materials
Deposition of wear-resistant and lubricating DLC functional films
Research of amorphous silicon and microcrystalline silicon thin film devices
Preparation of silicon nitride and silicon oxide insulating protective layers
Growth of carbon nanotube arrays and micro-nano functional materials
Preparation of optical anti-reflection, reflection and special coating layers
Surface treatment and interface modification of polymer materials
The D210 desktop PECVD features a compact structure and reasonable configuration, lowering the threshold for laboratory thin film research. It combines low-temperature plasma deposition and high-temperature thermal treatment functions, with flexible parameter adjustment and wide process compatibility.
Equipped with complete protection measures and visualized operation system, it delivers stable running performance and convenient daily maintenance. It is a practical experimental device for conventional material deposition and exploratory research in scientific research laboratories.
QR code

Contact information
15738867410
Online Message
Top